

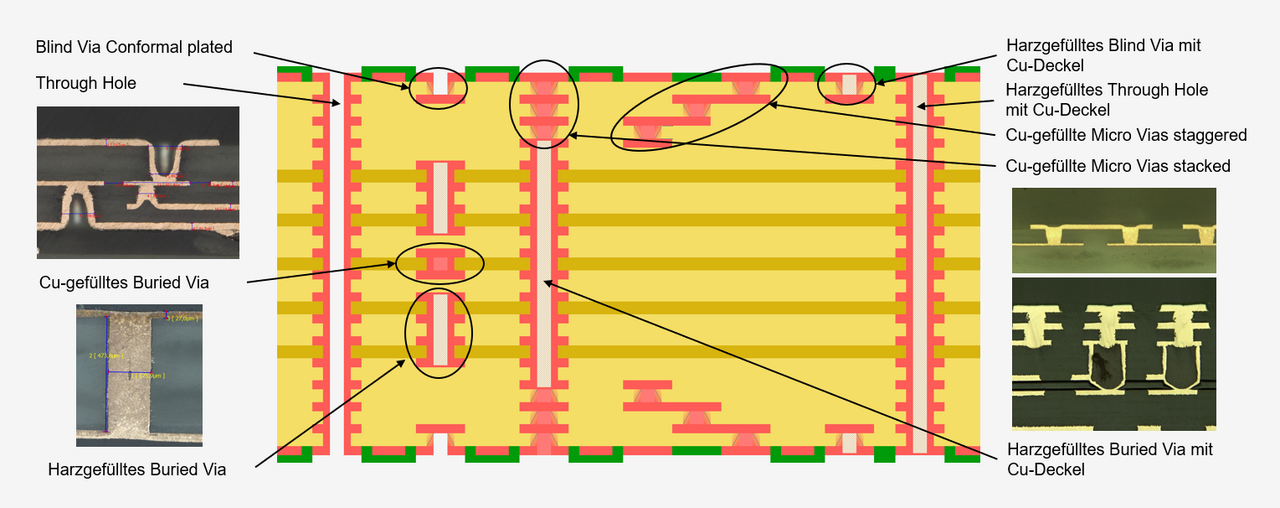



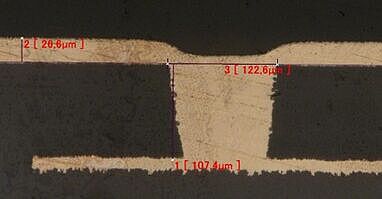
| Beschreibung | Standard | Sonder | |
|---|---|---|---|
| A | Leiterbahnbreite | ≥125µm | ≥50µm |
| B | Leiterbahnabstand | ≥125µm | ≥50µm |
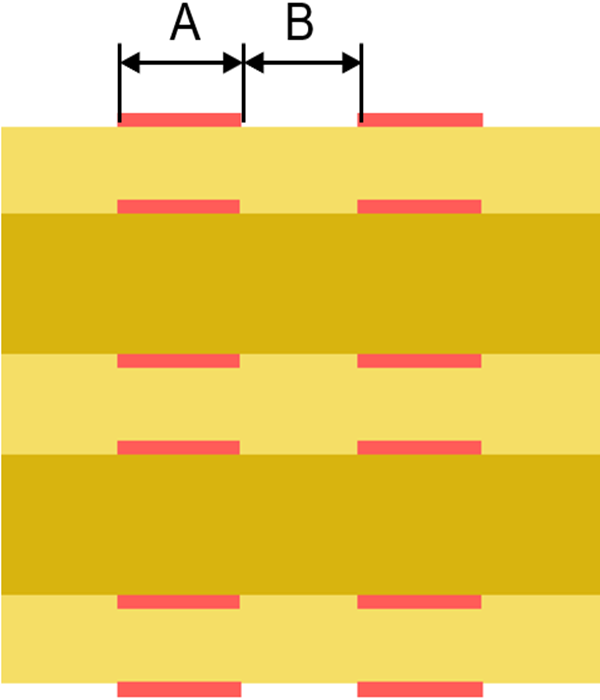
| Beschreibung | Standard | Sonder | |
|---|---|---|---|
| C | Bohrdurchmesser | ≥75µm | ≥40µm |
| D | Bohrtiefe (AR>1:1) | ≤100µm | >100µm |
| E | Restring Startpad umlaufend | ≥100µm | ≥50µm |
| F | Restring Landepad umlaufend | ≥100µm | ≥50µm |
| Verfüllung | Plugging Paste | Cu-Filling | |
| Cu-Deckel | Nach Kundenwunsch | Nach Kundenwunsch |